Technologie-Roadmap: „Kim's Law“-Professor liefert Vision vom Weg bis HBM8
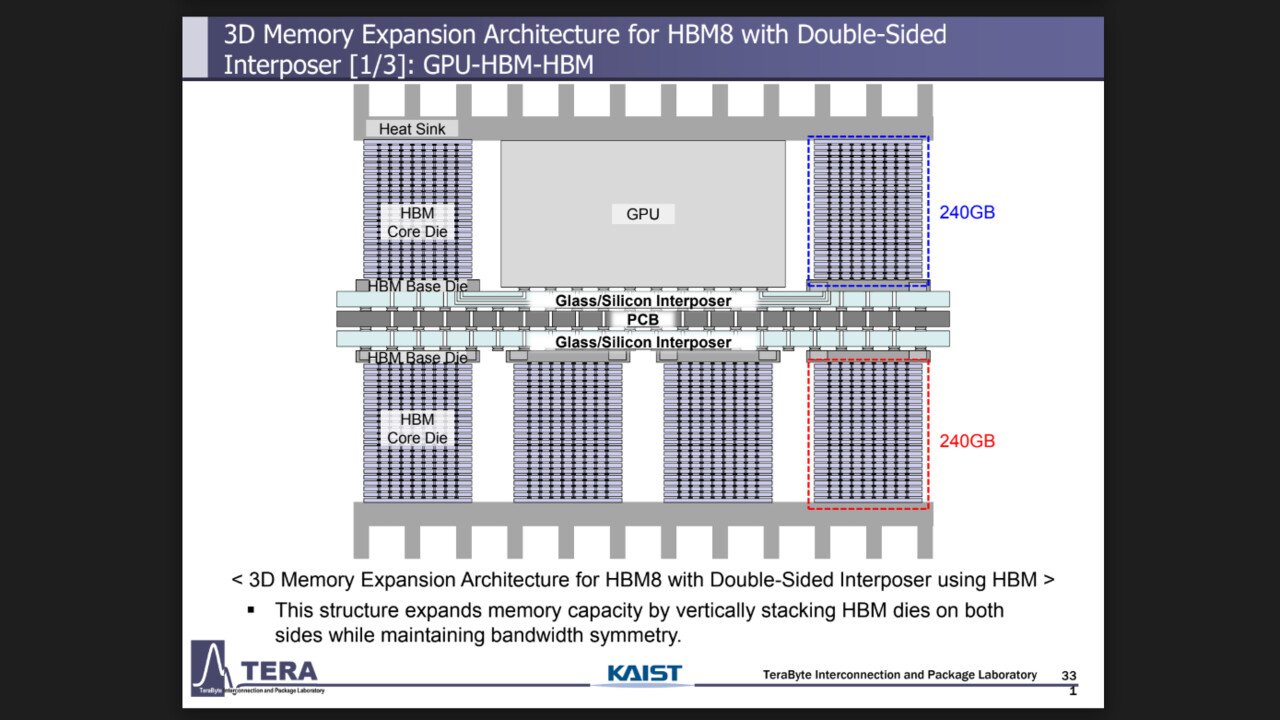
Das Teralab-Institut der KAIST-Universität aus Südkorea hat eine neue „HBM-Roadmap“ vorgestellt und parallel auf fast 400 Seiten dargelegt, wie die Entwicklung vom aktuellen HBM3e über HBM4, HBM5, HBM6 und HBM7 bis hin zu HBM8 im Jahr 2038 aussehen könnte. Wer sich für Chips und Packaging interessiert, ist hier richtig.
Achtung: keine offizielle Roadmap
Vorweg sei klargestellt: Bei der präsentierten Roadmap handelt es sich um keine offizielle Roadmap für High-Bandwidth Memory, sondern eine Prognose des Forschungsinstitutes, wie die Entwicklung bis zu HBM im Jahr 2038 aussehen könnte. Auch wenn es anderswo anders steht. Verantwortlich zeichnet sich Professor Joungho Kim, der im Jahr 2013 „Kim's Law“ als Nachfolger von „Moore's Law“ definiert hatte.
Während Moore's Law besagt, dass sich die Zahl der Transistoren integrierter Schaltkreise mit minimalen Komponentenkosten regelmäßig verdoppelt, bezieht sich Kim's Law auf die Anzahl der Lagen integrierter Schaltungen, die sich alle zwei Jahre verdoppeln würden.
Gute Kontakte in die Wirtschaft
Das Terabyte Interconnection and Package Laboratory (Teralab) am Korea Advanced Institute of Science and Technology (KAIST) besitzt als Institut der auf Forschung fokussierten, staatlichen Universität enge Kontakte zur Wirtschaft und blickt auf eine Reihe wichtiger Entwicklungen im Bereich der Speichertechnologien zurück. Aus der Luft gegriffen sind die Prognosen demnach nicht.
371 Seiten voll Packaging, Stacking und Glassubstrat
Der in einem 371 Seiten umfassenden PDF auch online verfügbare Workshop (Google Drive) ist zu umfangreich und zu komplex, um ihn auch nur im Ansatz zusammenfassen zu können – zumal die Roadmap und die in jeder HBM-Generation verwendeten Technologien rein hypothetischer Natur sind.
Wer sich für Chip-Technologien und insbesondere Packaging interessiert, kommt hier aber voll auf seine Kosten.
Ungeklebt und ungestapelt war gestern
Schon beim Überfliegen des Vortrags wird klar, dass Multi-Chip-Multi-Layer-Packages der heutigen Zeit schon in wenigen Jahren wie Basistechnologien wirken werden: Mehr Layer, komplexeren und – dank Glassubstraten – größeren Packages, die teilweise doppelseitig über einen Interposer (verbindet Chips) verfügen, gehört die Zukunft. Ob die Fortschritte am Ende so schnell kommen wie prognostiziert, bleibt abzuwarten. Unrealistisch ist der gezeichnet Weg aber nicht.
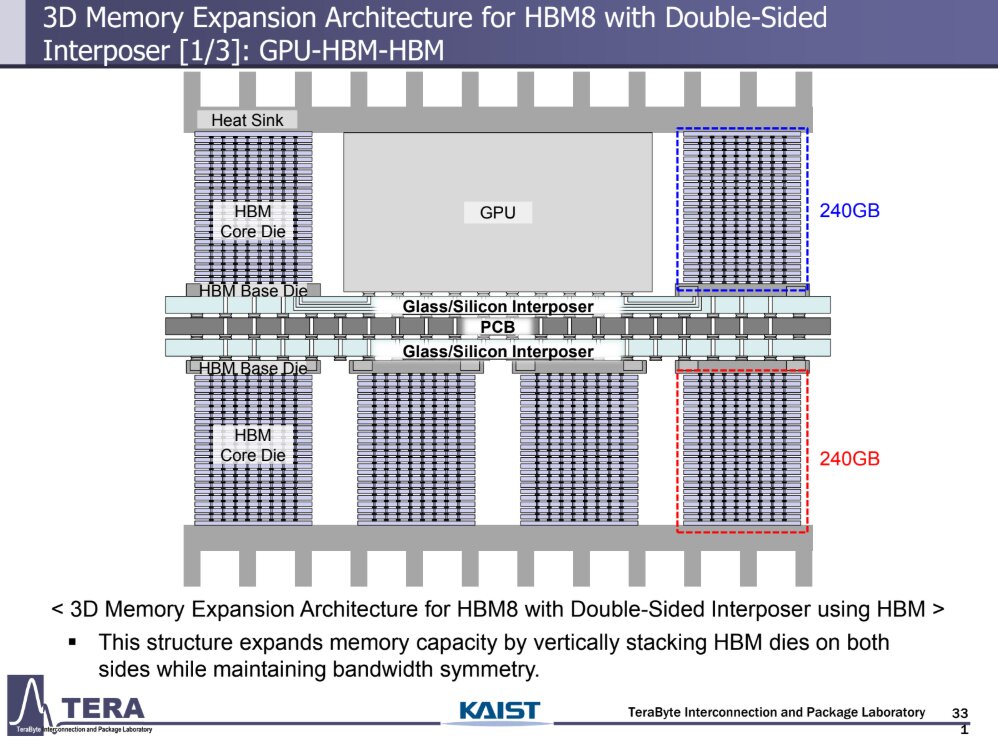
Auch per Videomitschnitt verfügbar
Wer des Koreanischen mächtig ist, kann sich auf YouTube auch Mitschnitte zum Vortrag ansehen.